- Integrierter Schaltkreis
-
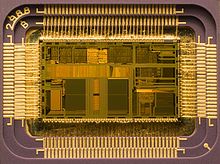 Integrierter Schaltkreis. Das Chip-Gehäuse wurde geöffnet und ermöglicht den Blick auf den eigentlichen Halbleiter. Die erkennbaren Strukturen im Zentrum sind die realisierte elektronische Schaltung. Im Außenbereich sind die goldenen Anschlussleitungen zu erkennen, welche die elektrische Verdrahtung zwischen IC und den Gehäusekontakten bildet.
Integrierter Schaltkreis. Das Chip-Gehäuse wurde geöffnet und ermöglicht den Blick auf den eigentlichen Halbleiter. Die erkennbaren Strukturen im Zentrum sind die realisierte elektronische Schaltung. Im Außenbereich sind die goldenen Anschlussleitungen zu erkennen, welche die elektrische Verdrahtung zwischen IC und den Gehäusekontakten bildet.
Ein integrierter Schaltkreis (auch integrierte Schaltung, englisch integrated circuit, kurz IC, Mikrochip) ist eine auf einem einzelnen (Halbleiter-)substrat (Chip, engl. die) untergebrachte elektronische Schaltung bestehend aus miteinander verdrahteten elektronischen Bauelementen. Er wird daher auch als Festkörperschaltkreis oder monolithischer Schaltkreis bezeichnet.
Inhaltsverzeichnis
Geschichte
 Integrierter Schaltkreis im DIP-Kunststoffgehäuse. Der integrierte Schaltkreis ist nicht sichtbar und befindet sich im Inneren des Kunststoffgehäuses.
Integrierter Schaltkreis im DIP-Kunststoffgehäuse. Der integrierte Schaltkreis ist nicht sichtbar und befindet sich im Inneren des Kunststoffgehäuses.
 Integrierter Schaltkreis im Zentrum, die gebondeten Anschlussdrähte sind gut zu erkennen
Integrierter Schaltkreis im Zentrum, die gebondeten Anschlussdrähte sind gut zu erkennen
Vor der Entwicklung integrierter Schaltungen Ende der 1950er Jahre wurden elektronische Schaltungen mit diskreten Bauteilen aufgebaut, d. h. mit einzelnen Transistoren, Dioden etc., die auf einer Leiterplatte zu einer Schaltung zusammengefügt wurden. Dies war hinsichtlich Größe und Lebensdauer bereits ein wesentlicher Durchbruch gegenüber den damals konkurrierenden Elektronenröhren. Zwar gab es schon vor der Erfindung des Transistors elektronische Bauelemente, die mehrere Funktionen in einem Bauteil integrierten, beispielsweise in Form von Mehrsystemröhre, Verbundröhre, Duodioden oder auch mehranodigen Quecksilberdampfgleichrichtern, die in einem Bauteil die Funktion mehrerer gesteuerter oder ungesteuerter Gleichrichter (eine Kathode und mehrere Anoden) vereinten. Doch die Vorteile durch den Einsatz von Transistoren und Leiterplatten (Platinen) wie Verkleinerung und geringere Leistungsaufnahme verdrängten die Systeme aus Elektronenröhren zunehmend. Dieser Trend verstärkte sich mit der Entwicklung und dem massiven Einsatz von integrierten Schaltungen ab den 1960er Jahren.
Der erste integrierte Schaltkreis (ein Flipflop) wurde im September 1958 von Jack Kilby entwickelt.[1] Er bestand aus zwei Bipolartransistoren, welche auf einem Germanium-Substrat befestigt und durch Golddrähte verbunden wurden. Dieser Hybrid-Schaltkreis ist somit ein erstes Beispiel der Umsetzung der schon bekannten Transistor-Transistor-Logik (TTL) auf einen Schaltkreis. Sie war eine Vorstufe zur Weiterentwicklung der TTL-Schaltungen hin zu kleineren Bauformen.
Der erste „monolithische“, d. h. aus bzw. in einem einzigen einkristallinen Substrat gefertigte integrierte Schaltkreis wurde von Robert Noyce im Juli 1959 zum Patent angemeldet.[2] Das Entscheidende an der Erfindung von Noyce war die komplette Fertigung der Bauelemente einschließlich Verdrahtung auf einem Substrat. Für die Herstellung wurden bereits fotolithografische Verfahren und Diffusionsprozesse genutzt, die Fairchild Semiconductor kurz zuvor für die Herstellung des ersten modernen Diffusions-Bipolartransistors entwickelt hatte.[1][3][4] Unter anderem auf diesen Techniken basierend wurden 1970/71 nahezu gleichzeitig die ersten Mikroprozessoren von drei Firmen vorgestellt: der Intel 4004, der Texas Instruments (TI) TMS 1000 und der Garrett AiResearch „Central Air Data Computer“ (CADC).
Die ersten integrierten Schaltkreise in Serienproduktion entstanden bereits Anfang der 1960er Jahre (v. a. bei Texas Instruments und Fairchild Semiconductor). Sie bestanden lediglich aus bis zu wenigen Dutzend Transistoren (engl. small-scale integration, SSI). Mit den Jahren wurden die Bauelemente jedoch immer weiter verkleinert, passive Bauelemente wie Widerstände integriert sowie die Komplexität der integrierten Schaltkreise gesteigert. Damit erhöhte sich auch die Anzahl der Transistoren pro Chip beziehungsweise pro Flächeneinheit; dabei war die Anzahl der Transistoren die wichtigste Kenngröße von ICs.
Mit der medium-scale integration (MSI) fanden einige hundert Transistoren, bei der large-scale integration (LSI) Anfang der 1970er einige tausend Transistoren Platz auf einem Chip. Damit war es erstmals möglich, einen ganzen Hauptprozessor (CPU) als sogenannten Mikroprozessor auf einem Chip zu integrieren, was die Kosten für Computer extrem reduzierte. Anfang der 1980er folgte die very-large-scale integration (VLSI) mit einigen hunderttausend Transistoren, mittels derer man schon bald Speicherchips (RAM) mit einer Kapazität von 256 KBit und 1 MBit herstellen konnte. Mit dieser Weiterentwicklung der Fertigungstechnologie ging eine immer höhere Entwurfsautomatisierung (siehe Chipentwurf) des Designs und der zur Fertigung erforderlichen Fotomasken einher, ohne die eine Entwicklung komplexerer Schaltungen nicht mehr möglich war.
Im Jahr 2010 enthalten Grafik-Prozessoren bis zu 3 Milliarden Transistoren (siehe Nvidia Tesla), „normale“ General-Purpose-CPUs bis zu 1,17 Milliarden Transistoren (Intel Core i7-980X). Der Itanium 2 Tukwila besteht aus 2,05 Milliarden Transistoren.
Jacobi-Patent
Kaum bekannt ist der bereits 1949 von Werner Jacobi erfundene und patentierte „Halbleiterverstärker“,[5] eine auf einem als Trägermaterial dienenden Halbleiter aus fünf Transistoren bestehende Schaltung. Diese bilden eine dreistufige Verstärkerschaltung in Form eines integrierten Schaltkreises. Zwei Transistoren werden „über Kopf“ geschaltet und bewirken damit die Impedanzwandlung zwischen den Transistorstufen. Jacobi hält fest, dass damit zum Beispiel Hörgeräte klein, leicht und billig realisiert werden können.
Eine umgehende wirtschaftliche Nutzung seines Patentes ist nicht bekannt. Die Formulierung des Integrationsgedankens in der am 15. Mai 1952 bekannt gemachten Patentschrift lautet: „Halbleiterverstärker, dadurch gekennzeichnet, daß auf den Halbleiter mehrere in verschiedenen Schalt- bzw. Verstärkerstufen wirkende Elektrodensysteme aufgesetzt werden.“ Damit geht zum Beispiel die Integration mehrerer Leuchtdioden in ein Gehäuse im Grundgedanken auf Jacobi zurück.
Arten und Anwendung integrierter Schaltungen
Das Hauptmerkmal von integrierten Schaltungen ist eine große Zahl an verschiedenartigen oder gleichen aktiven und passiven Bauelementen – zu letzteren gehören Widerstände und Kondensatoren – sowie verbindenden Leiterzügen auf oder in einem einkristallinen Substrat. Damit bilden sie das Pendant zu Schaltkreisen aus auf einer Leiterplatte gelöteten einzelnen (diskreten) Bauelementen. Eine Zwischenstellung nehmen Dickschicht- und Dünnschichtschaltungen – wobei Bauteile durch Aufdampfen und Strukturieren einer dünnen Schicht auf einem Glassubstrat hergestellt werden – sowie (Hybridschaltkreise) ein. Es gibt eine Reihe weiterer Unterscheidungen:
Nach der Fertigungstechnologie:
- monolithische Schaltkreise: es werden alle Bauelemente auf einem einzigen Stück (Substrat) einkristallinen Halbleitermaterials (Chip) hergestellt; die Schaltkreise werden dabei meist durch Dotierung oder Epitaxie an der Oberfläche des Substratmaterials (Dioden, Transistoren, bis zu einigen Mikrometern ober- und unterhalb der ursprünglichen Oberfläche) oder durch Schichtauftrag (Widerstände, Leiterzüge, Kondensatoren, Isolationen, Gates von MOSFET, Epitaxie) gefertigt.
- Dünnschicht-Schaltkreise sind Bauelemente, die durch Bedampfen auf einem Glassubstrat hergestellt werden. Es handelt sich meist um Widerstands-Netzwerke. Sie können durch Elektronenstrahlabgleich auch in höchster Genauigkeit gefertigt werden. Sie sind durch Tauchlackierung geschützt. Ebenfalls in diese Gruppe gehören Schaltungen aus Dünnschichttransistoren (TFT), wie sie z. B. in Flachbildschirmen Anwendung finden.
- Dickschicht-Hybridschaltkreise vereinen mehrere monolithische Chips sowie gedruckte Leiterzüge und passive Bauteile (fast nur Widerstände) in Dickschicht-Technologie meist auf einem Keramikträger; sie sind oft tauchlackiert.
Nach der Signalart:- Digitale ICs verarbeiten oder speichern Signale, die in Form von wenigen diskreten Pegeln vorliegen.
- Analoge (Linear-) ICs verarbeiten Signale mit beliebigen Zwischenwerten.
- Mixed-Signal-ICs haben sowohl analoge als auch digitale Schaltungsteile.
Sensor- und Aktor-ICs sind Wandler zwischen unterschiedlichen physikalischen Größen, die mit mikroelektronischen Technologien gefertigt werden. Beispiele sind ICs in CMOS-Kameras, Mikrospiegelaktoren, Hallsonden, Beschleunigungssensoren oder Schaltkreise zur Messung ihrer Temperatur, der Beleuchtungsstärke oder zum Empfang digitaler Infrarot-Signale
Nach der Aufgabe:- Prozessoren dienen als Rechen- und Steuereinheiten von Computern
- Halbleiterspeicher speichern digitale Daten
- Standard-Logik-ICs verschiedener Logikfamilien bieten anwendungsübergreifende Funktionen
- ASICs sind anwendungsspezifische Entwicklungen (z. B. in Toastern, im Kfz, in Waschmaschinen)
- ASSPs sind anwendungsspezifische Standardprodukte, die ähnlich wie ASICs Spezialanwendungen haben, aber vom Hersteller angeboten werden und nicht auf Wunsch des Kunden gebaut werden
- Sensor-ICs wandeln und verarbeiten nichtelektrische Größen (z. B. Beschleunigung, Licht, Magnetfelder)
- DSPs (digitale Signalprozessoren) verarbeiten digitale Signale oder analoge Signale in digitaler Form
- D/A- und A/D-Wandler wandeln digitale in analoge Werte oder umgekehrt
- FPGAs (engl. field programmable gate array) sind vom Kunden konfigurierbare digitale ICs, die aus einer Vielzahl von zusammenschaltbaren Funktionseinheiten bestehen
- Mikrocontroller (µC) enthalten alle Teile eines kleinen Computers (Programmspeicher, Rechenwerk, Arbeitsspeicher und Register)
- Leistungs-ICs können hohe Ströme und Spannungen verarbeiten (z. B. als komplette Leistungs-Verstärker oder in Netzteilen)
- System-on-a-Chip (SoC) sind größere Systeme, die auf einem Chip vereint werden.
Herstellung
Die Fertigung von integrierten Schaltungen erfolgt vollständig auf Wafern (einkristalline Halbleiterscheibe), man spricht daher auch von einer „monolithischen Fertigung“ oder „monolithischen Integration“. Dabei werden auf einem Wafer Hunderte und bei einfachen Strukturen (z. B. Einzeltransistoren) mehrere Tausende identische integrierte Schaltkreise parallel hergestellt, was unter anderem die Herstellungskosten senkt. Der Fertigungsprozess kann (neben Funktionstests) in drei grundlegende Abschnitte eingeteilt werden:
- Die Substratherstellung, dazu gehört die Aufreinigung des Ausgangsmaterials, Herstellung von großen Einkristallen (sog. Ingots) und Einzelsubstraten (Wafern)
- Die Herstellung der einzelnen Bauelemente auf einem Wafer, das sogenannte Front-End. Dieser Schritt lässt sich nochmals unterteilen in:
- Front-End-of-Line (engl. front-end of line, FEOL, dt. ‚vorderes Ende der Produktionslinie‘): Hier werden die (aktiven) Bauelemente wie Transistoren, Dioden oder Kondensatoren durch die Bearbeitung des Substratmaterials hergestellt.
- Back-End-of-Line (engl. back-end of line, BEOL, dt. ‚hinteres Ende der Produktionslinie‘): Dieser Schritt umfasst im Wesentlichen die sogenannte Metallisierung, bei der die im FEOL gefertigten Bauelemente miteinander verbunden werden, und die abschließende Passivierung der Oberfläche.
- Das Zerteilen der Wafer in Einzelchips und deren Verpacken in Gehäuse, das sogenannte Back-End (nicht zu verwechseln mit Back-End-of-Line).
Eine „hybride Integration“ (Hybridtechnik) – eine Kombination von Bauelementen aus unterschiedlichen Werkstoffen und Fertigungsprozessen, wie der Dünn- und Dickfilmtechnik – wie sie unter anderem bei der Herstellung von Mikrosystemen genutzt wird, findet bei der Herstellung von integrierten Schaltkreisen bislang keine Anwendung. Ein vergleichbarer Aufbau, der 3D-Integration, bei dem mehrere Chips übereinandergestapelt und elektrisch miteinander verbunden werden, könnte aber in zukünftigen ICs Verwendung finden, vgl.Multi-Chip-Modul.
Substratherstellung
Das Grundmaterial (Substrat) dient in der Regel nicht nur als Träger sondern auch als Basismaterial für die aktiven Gebiete von Dioden und Transistoren. Die überwiegende Mehrzahl (mehr als 99 %) der integrierten Schaltkreise nutzt als Substratmaterial Silicium. Für sehr hochfrequente oder optische Anwendungen kommen auch andere Materialien wie Galliumarsenid zum Einsatz. Für spezielle Anwendungen werden auch sogenannte Silicon-on-Insulator-Substrate (SOI-Substrate) oder Silicium auf dem isolierenden Substrat wie Saphir verwendet (engl. Silicon-on-Sapphire, SOS).
Damit die hohen Anforderungen der Mikroelektronik erfüllt werden können, ist es notwendig, das Substrat in Form von hochreinen Einkristallen herzustellen. Im Falle des Siliciums wird zunächst aus einer hochreinen Siliciumschmelze (vgl. Gewinnung von Reinsilicium) ein einkristalliner Zylinder (Ingot) gezogen. Dazu wird vornehmlich das sogenannte Czochralski-Verfahren (CZ-Verfahren) genutzt. Ein alternatives Verfahren ist das Zonenschmelzen, was auch zur weiteren Reinigung der CZ-Ingots eingesetzt werden kann; für einige Spezialanwendungen sind höhere Reinheitsgrade notwendig als ein Fremdatom auf 109 Atomen der CZ-Ingots. Aus den Ingots werden in 0,5–1,5 mm dünne Scheiben, die sog. Wafer, zersägt. Die heute in der Massenproduktion verwendeten Siliciumwafer haben Durchmesser von 6, 8 oder 12 Zoll (entsprechend 150, 200 oder 300 mm). Sie erhalten durch verschiedene Ätz-, Schleif- und Polierprozesse eine nahezu perfekte ebene Oberfläche mit Unebenheiten in der Größenordnung kleiner einem Nanometer, das heißt nur wenigen Atomlagen.
Front-End
Das sogenannte Front-End bei der Fertigung von integrierten Schaltkreisen beschäftigt sich mit der Herstellung der elektrisch aktiven Bauelemente (Transistoren, Kondensatoren, usw.), dem sogenannten Front-End-Of-Line, und deren Verdrahtung (Metallisierung), dem sogenannten Back-End-Of-Line. Eingesetzt werden hier die Verfahren der Halbleitertechnik zum Schichtaufbau (Epitaxie, Sputterdeposition, Bedampfen, CVD usw.), Schichtabtrag, Strukturierung (Fotolithografie) und zu Änderung von Materialeigenschaften (z. B. Dotierung). Die Fertigung erfolgt in extrem sauberer Umgebung, so genannten Reinräumen, mit einer sehr geringen Dichte von Staubpartikeln. Dies ist nötig, weil selbst kleinste Partikel (< 0,1 µm) bereits den Ausfall eines kompletten Schaltkreises verursachen können.
Eine der wichtigsten da meistverwendeten Halbleitertechniken ist die Fotolithografie. Sie dient zur Strukturierung von Fotolackmasken, die in den nachfolgenden Schritten Bereiche auf dem Wafer abdecken, die nicht behandelt (z. B. dotiert) werden sollen. Dazu wird zunächst ein Fotolack auf den Wafer aufgebracht und über eine Fotomaske belichtet, je nach verwendetem Lacktyp (Positiv- oder Negativlack) verbleiben die belichteteten oder unbelichteten Bereich nach der Entwicklung des Fotolacks auf dem Wafer. Diese Bereiche dienen für nachfolgende Prozessschritte wiederum als Maske direkt auf dem Wafer. Da eine solche Strukturierung vor fast jedem anderem Prozessschritt benötigt wird, ist die Fotolithografie der meist verwendete Prozessschritt im Front-End überhaupt.
Die Front-End-Fertigung eines typischen Mikroprozessors startet mit der Herstellung der Isolationsbereiche zwischen den einzelnen Bauelementen. Heutzutage (2009) wird hierzu weitgehend die sogenannte Grabenisolation (engl. shallow trench isolation, STI) genutzt. Nachdem die Oberfläche weitgehend durch chemisch-mechanisches Polieren (CMP) eingeebnet wurde, erfolgt die Herstellung der unterschiedlich dotierten Wannen für die späteren Transistoren. Die Dotierung erfolgt heutzutage (2009) meist mittels Ionenimplantation ganzflächig über den Wafer. Um die Bereiche zu schützen, die nicht oder anders dotiert werden sollen, müssen diese mithilfe einer Lackmaske abgedeckt werden.
Die nachfolgenden Prozessschritte dienen zum Aufbau des Gate-Schichtstapels. Im Falle eines derzeit (2009) üblichen CMOS-Prozesses mit Siliziumdioxid als Gatedielektrikum und Polysilizium als Gateelektrode wird zunächst das sehr dünne (wenige Nanometer) dicke Gateoxid durch „Rapid Thermal Oxidation“ (RTO) hergestellt. Danach folgt ein ganzflächigen Schichtstapel aus per LPCVD abgeschiedenem Polysilizium, einer dünnen Verkapselungsschicht aus Siliziumdioxid (dient später als Hardmaske für die Gatestrukturierung) und Fotolack. Anschließend wird der Fotolack fotolithographisch strukturiert und das Gate durch reaktives Ionenätzen (RIE) freigeätzt (anisotrop, senkrecht zur Waferoberfläche). Da heutzutage (2009) die Gatelänge (45 nm und kleiner) in den Spitzenprodukten der Prozessorhersteller kleiner ist als es die eingesetzte Fotolithografietechnik erlaubt, wird die Fotolackmaske vor dem RIE-Schritt noch durch einen isotropen Trockenätzprozess verkleinert.
Nach der Gatestrukturierung werden die Source- und Drain-Gebiete dotiert. Dies beinhaltet die Dotierung der Oberflächen- (engl. shallow implants) und Haloimplantate, die Spacer-Strukturierung sowie die abschließende Dotierung der Source- und Drain-Gebiete für typische LDD-MOSFETs (LDD = engl. lightly doped drain). Mit der Fertigung der Source- und Drain-Gebiete ist der eigentliche FEOL-Fertigungsabschnitt beendet. Nun beginnt die Kontaktierung und Verknüpfung der Transistoren.
Der Abschnitt der Kontaktfertigung wird nicht eindeutig dem FEOL oder BEOL zugeordnet, deshalb wird dieser Abschnitt auch manchmal als Middle-of-Line (MOL) bezeichnet. Die verwendeten Techniken sind im Wesentlichen die gleichen wie im BEOL. Dazu zählt die Abscheidung und Einebnung des Zwischendielektrikum – meist undotiertes Silikatglas (engl. undoped silcat glass, USG) oder Low-k-Dielektrika (zunehmend seit Mitte der 2000er Jahre) – sowie die Herstellung der Kontaktlöcher mittels RIE. Diese werden anschließend über ein CVD-Verfahren mit Wolfram gefüllt.
Nun folgt das eigentliche BEOL, der Metallisierung, das heißt die Herstellung eines Netzwerks aus Leiterbahnen, mit denen die einzelnen Bauelemente verbunden werden. Typische Materialien sind Aluminium bzw. seit Ende der 1990er oft auch Kupfer. Die Herstellung der Leiterbahnen ist dabei stark vom verwendeten Metall abhängig. So wird bei Aluminium in der Regel zunächst das Metall ganzflächig abgeschieden und anschließend mithilfe der Fotolithografie und einem Trockenätzprozess strukturiert. Diese Methode ist bei Kupfer nicht möglich, da es keinen Trockenätzprozess für Kupfer gibt, bei dem gasförmige Reaktionsprodukte entstehen. Stattdessen erfolgt bei Kupfer zunächst eine Strukturierung der ganzflächig abgeschiedenen Isolationsschicht und danach die Kupfermetallisierung mittels galvanischer Verfahren. Hierbei kommen im Wesentlichen zwei Techniken zum Einsatz: der Damascene- und Dual-Damascene-Prozess. Sie unterscheiden sich in der Art wie die elektrischen Verbindungen, genannt VIA (engl. vertical interconnect access), zwischen den eigentlichen Leiterbahnebenen gefertigt werden (einzeln oder zusammen mit den Leiterbahnebenen). Die VIAs entsprechen den Durchkontaktierungen bei mehrschichtigen Leiterplatten. In der Abbildung sind es die orange, senkrechten Strukturen. In einem fertigen integrierten Schaltkreis befinden sich dann bis zu 11 solcher Metallisierungsebenen übereinander. Die Strukturgröße nimmt dabei stufenweise in höheren Ebenen zu, beispielsweise sind die ersten beiden Ebenen in der kleinstmöglichen Strukturgröße (1x) gefertigt und anschließend folgen 2 bis 5 Ebenen mit einem größeren Strukturabstand (z. B. 2x) dies sich bis zu 16-fach (16x) gröberen Strukturen in der obersten Ebene fortsetzen.
Neben dieser konventionellen Metallisierung gibt es auch weitere Techniken wie Silizium-Durchkontaktierung (engl. through-silicon via, TSV). Sie wird derzeit bei einigen Sensoranwendungen eingesetzt, bei denen bestimmte Funktionen sowohl auf der Vorder- als auch auf der Rückseite der Chips benötigt werden, beispielsweise bestimmte Biosensoren. Sie gilt aber auch als eine zukunftsträchtige Technik zur Realisierung eine künftigen 3D-Integration von integrierten Schaltkreisen. Dabei werden mehrere (stark abgedünnte) Chips übereinander gestapelt und die einzelnen Chipebenen elektrisch durch TSVs miteinander verbunden. Da in beiden Fällen die TSVs durch den Wafer verlaufen, spricht man auch von wafer level through-silicon via (dt. Silizium-Durchkontaktierung durch den Wafer), siehe auch ITRS 2009.[6]
Bei einigen Bauelementen, wie beispielsweise IGBT, werden zusätzlich die der Schaltung entgegengesetzte Seite metallisiert, um einen leitenden Kontakt herzustellen; allerdings mit nur einer oder zwei Metallisierungsebenen.
Back-End
Zur Verwendung auf einer Leiterplatte muss der empfindliche Chip in ein Gehäuse eingebaut werden.
Im sogenannten Back-End werden die Wafer in die Einzelchips zerteilt und in der Regel in ein Gehäuse eingebracht.
Vor dem Zerteilen werden die Wafer häufig durch Schleifen abgedünnt, das sogenannte „Backlapping“. Die Abdünnung wird vorgenommen, um das Kühlverhalten des Chips zu verbessern. Dies ist möglich, da sich bei integrierten Schaltkreisen in Dünnschichttechnik elektrisch aktive Gebiete nur in den ersten Mikrometern an der Oberfläche der Strukturseite befinden. Das restliche Substratmaterial, dient nur noch der mechanischen Stabilität. Bei gesägten Chips ist jedoch die volle Substratdicke nicht mehr notwendig. Dicke Substrate weisen jedoch einen höheren Wärmeleitwiderstand auf. Da die Kühlkörper in der Regel auf der Substratrückseite angebracht werden, besitzen abgedünnten Wafer (ca. 100 bis 200 µm dick) ein besseres Kühlverhalten.
Das Zerteilen der Wafer in die einzelnen Dies erfolgt in der Regel durch Sägen (selten auch durch Ritzen und Brechen). Damit die Dies beim Sägen nicht auseinanderfallen, wird vor dem Sägen der Wafer auf eine Sägefolie aufgeklebt. Da die Säge ein Stück aus dem Wafer entfernt, sind die Chips nicht nahtlos nebeneinander angeordnet, sondern haben einen gewissen Abstand. In diesen Bahnen (dem sog. „Ritzrahmen“) sind zudem Teststrukturen aufgebracht, die unter anderem zur PCM-Messung unmittelbar nach der Front-End-Fertigung genutzt werden. Diese Teststrukturen werden beim Sägen zerstört.
 Chips in oberflächenmontierten Plastikgehäusen auf einer Computer-Platine (Makroaufnahme)
Chips in oberflächenmontierten Plastikgehäusen auf einer Computer-Platine (Makroaufnahme)
Beim nachfolgenden Verpacken (engl. packaging) werden die einzelnen ICs dann in ein Gehäuse eingebracht und kontaktiert, das sogenannte Bonden. Dabei kommen je nach Typ unterschiedliche Verfahren zum Einsatz, beispielsweise Chipbonden oder Drahtbonden. Das Verkappen (Einhausen) dient zur hermetischen Versiegelung gegenüber Umwelteinflüssen – für rein elektrische Schaltkreise muss das Gehäuse gas- und lichtdicht sein – sowie zur besseren Verwendbarkeit. Entweder wird der Chip samt Bonddrähten in einem Hohlraum (Blech, Keramik, ggf. mit Fenster) eingeschlossen oder mit Kunstharz umhüllt (eingegossen, Spritzgusstechnik). Hochkomplexe Schaltkreise (meist für mobile Anwendungen) werden neuerdings (2009) auch ohne Sockelgehäuse eingesetzt und direkt auf die jeweiligen Platinen gelötet (vgl. Ball Grid Array). Zum Abschluss erfolgt nochmals ein Funktionstest, dabei werden zugesicherte Eigenschaften an allen Schaltkreisen geprüft. Die Typprüfung erfolgt stichprobenartig oder nur in der Entwicklungsphase. Die Stückprüfung dient dem Sortieren in Schaltkreise unterschiedlicher Güteklassen (zum Beispiel nach Offset-Spannung bei Operationsverstärkern) Prüfergebnisse und die Art der Verkappung bestimmen das Einsatzgebiet. So werden hohe Qualitäten für erweiterte Einsatztemperaturen und Umweltanforderungen gefertigt (sog. MIL-Standard für militärische und Raumfahrt-Anwendungen). Höhere Toleranzen und Plastik-Verkappung kommen für Massenanwendungen (Konsumgüter) in Frage.
Als letzter Schritt wird das Gehäuse mit Informationen des Herstellers bedruckt, z. B. mit dem Herstellernamen, der Typennummer, dem Herstellungsdatum u. ä.). Die Back-End-Fertigung wird im Gegensatz zur Front-End-Fertigung von Mikromechanik und Verfahren der Kunststoffbearbeitung (Spritzguss) dominiert.
Funktionstests und Prozessüberwachung
Um schon frühzeitig auf Prozessschwankungen zu reagieren, fehlerhafte Prozesse gegebenenfalls zu korrigieren oder gar Wafer oder Lose aus der Produktion zu nehmen, werden die noch unfertigen ICs nach vielen Prozessschritten getestet. Im Front-End handelt es sich dabei meist um Stichproben in Form eines PCM-Tests (engl. process control monitoring, dt.: Prozessüberwachung). Für die Bestimmung von technologischen Parametern erfolgt die Prüfung (beispielsweise Schichtdickenprüfung) meist direkt nach dem jeweiligen Prozess, hier ist es mitunter wichtig auch die jeweiligen Anlagen mit zu erfassen, da auch baugleiche Anlagen mit denselben Parametern Abweichungen erzeugen, die außerhalb des Toleranzbereichs liegen können. Nach dem Front-End werden in der Regel alle ICs vor der Weiterverarbeitung auf ihre Funktion getestet. Dabei werden die wichtigsten elektrischen Parameter der verwendeten Bauelemente an speziellen Teststrukturen ermittelt, die sich in den Ritzgräben zwischen den Chips befinden. Die Parameter müssen bestimmte Spezifikationen einhalten, um sicherzustellen, dass die Chips im gesamten zulässigen Temperaturbereich und über die volle spezifizierte Lebensdauer zuverlässig arbeiten. Teilweise sind bestimmte Funktionen (HF-Schaltungen oder später nicht auf PINs herausgeführte Anschlüsse des Chips) nur auf dem Die testbar. Vor allem muss aus Kostengründen verhindert werden, dass nicht funktionsfähige ICs im nachfolgenden Herstellungsprozess weiterbearbeitet werden.
Obwohl diese Messungen auf speziellen Testsystemen (Automatic Test Equipment) vollautomatisch ablaufen, haben die damit verbundenen Kosten bei hochintegrierten Prozessorchips bereits nahezu die Herstellungskosten erreicht. Dies liegt vor allem daran, dass nur bedingt Skaleneffekte beim Testen greifen (eine Parallelisierung ist beispielsweise nur bei reinen Digitalschaltungen möglich) und neuere ICs immer mehr Funktionen beinhalten, die nacheinander getestet werden müssen. Um die feinen Strukturen der Mikroelektronik auflösen zu können, werden heutzutage Starrnadeladapter eingesetzt, mit welchen ein Messpunktabstand von 150 µm aufgelöst werden kann. Durch das präzise Führen der Starrnadeln können mit solchen Adaptern Kontaktstellen mit einem Durchmesser von 70 µm abgegriffen und geprüft werden. Als weiteres ermöglicht der Starrnadeladapter auch das Kontaktieren von feinpoligen Mikrosteckern, welche heutzutage in der Mikroelektronik immer mehr ihre Anwendung finden. Somit müssen solche Stecker nicht mehr mit dem schnell verschlissenen Gegenstecker kontaktiert werden. Bei allen neuen FE-Technologien wird eine Lernkurve durchlaufen, die sich u. a. an der Ausbeute funktionierender Bausteine messen lässt (Yield). Da eine neue FE Technologie erhebliche Entwicklungskosten (z. T. 3-stellige Millionenbeträge) beinhaltet, haben die Firmen ökonomische Vorteile, die möglichst schnell hohe Yield Werte erzielen.
Schließlich wird auch der gehäuste Chip vor der Ablieferung einem endgültigen Test unterzogen, um Fehler in der Back-End-Fertigung festzustellen. Auch werden einige Eigenschaften getestet, die sich durch das Packaging verändern, bzw. deren Messung ohne Gehäuse nicht möglich ist, wie z. B. das Bonding oder bestimmte Hochfrequenzeigenschaften. Der gehäuste Chip kann dann zur Leiterplattenbestückung gehen.
Miniaturisierung
Integrierte Schaltkreise werden als eigenständiges elektronisches Bauteil betrachtet. Die Größe des IC-Substrats (englisch die) beträgt dabei in der Regel nur wenige Quadratmillimeter und ist erheblich kleiner als das umgebende Gehäuse, das die eigentlichen elektrischen Anschlüsse (Pins) in handhabbarer Größe zum Verlöten bereithält. Um die Produktionskosten der oft komplexen und herstellungsaufwendigen ICs möglichst gering zu halten, werden in der Mikroelektronik mehrere (hundert bis tausend) integrierte Schaltkreise parallel auf so genannten Wafern hergestellt, die dabei auftretenden Produktionstoleranzen und -fehler verhindern allerdings eine hundertprozentige Ausbeute.
Um die Produktionskosten in nachfolgenden Generationen komplexerer ICs möglichst konstant zu halten oder gar zu senken, werden in der Mikroelektronik zwei große Trends vollzogen. Zum einen wird die Chip-Fläche für den einzelnen IC möglichst gering gehalten (Haupttrend) zum anderen werden möglichst viele ICs auf einem Wafer untergebracht, während das Gehäuse anderen Anforderungen Rechnung trägt (Löttechnologie, Wärmeableitung, etc.) und je nach Marktanforderung auch verschiedene Ausprägungen zeigt.
Die möglichst konstant gehaltene Chip-Fläche hat bei immer komplexer werdenden Schaltkreisen zur Folge – moderne integrierte Schaltkreise wie z. B. Speicherbausteine und Mikroprozessoren können mehrere hundert Millionen Bauteile (insbesondere Transistoren) enthalten –, dass die einzelnen Bauelemente wie Transistoren verkleinert werden müssen, was ebenfalls eine höhere Taktung und eine verringerte Betriebsspannung und daher Leistungsaufnahme ermöglicht. Bei konstanter Chip-Fläche können aber kaum Kosten durch höhere Parallelität bei der Herstellung gespart werden. Daher wurde die Standard-Wafer-Größe in der Produktion von 2-Zoll-Wafern auf heute 12-Zoll-Wafern (wirklicher Durchmesser 300 mm) erhöht. Mit der steigenden Wafer-Größe ging auch eine effizientere Ausnutzung der Wafer-Fläche einher (weniger Verschnitt). Um allerdings die Produktionsqualität dabei nicht nur gleich zuhalten sondern zu verbessern – was aufgrund kleiner Bauelemente notwendig war – mussten große Herausforderungen in der Beschichtungstechnologie überwunden werden.
Im Allgemeinen werden also bei der Miniaturisierung der Schaltkreise folgende Ziele verwirklicht:
- Ein Ziel ist eine effizientere Fertigung, dies wird unter anderem durch parallele Fertigung auf einem Substrat (englisch wafer) und somit der Einsparung von Rohstoffen bei der Produktion und der Weiterverarbeitung erreicht.
- Weiterhin sollen die Bauelemente effizienter im Betrieb werden, so ermöglicht die Verkleinerung der Strukturen eine Erhöhung der Schaltgeschwindigkeiten, dies wird beispielsweise durch kürzere Leitungslängen und somit kürzere Signallaufzeiten sowie geringeren Latenzzeiten beim Umladen der Kapazitäten in den Bauelementen erreicht, und durch Verringerung der Leistungsaufnahme der ICs.
- Durch die Integration weiterer Funktionen können neue ICs oft die Funktionalität mehrerer vorher diskreter ICs in sich vereinen, damit kann auch die Zuverlässigkeit erhöht werden, was vor allem in der Anfangsphase der integrierten Schaltkreise ein wichtiger Vorteil gegenüber konventionellen, gelöteten Schaltungen darstellte.
Auf diese Weise sollen kleinere, leistungssparendere Bauelemente mit immer mehr Funktionen hergestellt werden, dies ist vor allem bei mobilen Geräten wichtig. Die integrierten Schaltungen und deren Miniaturisierung ermöglicht so Telefon-, SIM-, Geld- und Kreditkarten, RFID, intelligente Sensoren, kleinere und langlebigere Herzschrittmacher oder Hörgeräte sowie MP3-Abspielgeräte oder CMOS-Kameras, u. a. in Mobiltelefonen.
Anwendungsbereiche
Integrierte Schaltkreise bilden heute die Grundlage jeglicher komplexer Elektronik, insbesondere der Computertechnik. Erst durch die Integration ist es möglich, umfangreiche Funktionalität auf kleinem Raum zur Verfügung zu stellen. Darüber hinaus ermöglichen integrierte Schaltkreise in vielen Fällen überhaupt auch erst die technische Realisierung von Systemen, die sonst zu teuer, zu komplex, zu leistungsintensiv oder zu groß wären.
Siehe auch
- Halbleiterhersteller
- Integrierter optischer Schaltkreis
- Applikationsspezifische Standardprodukte (ASSP)
- Mooresches Gesetz
- Common-centroid-Layout
- Robert Widlar, Gordon Moore, Marcian Edward Hoff
Weblinks
 Commons: Integrierter Schaltkreis – Album mit Bildern und/oder Videos und Audiodateien
Commons: Integrierter Schaltkreis – Album mit Bildern und/oder Videos und AudiodateienEinzelnachweise
- ↑ a b Jack S. Kilby: Invention of the integrated circuit. In: IEEE Transactions on Electron Devices. 23, Nr. 7, 1976, S. 648–654.
- ↑ Patent US2981877: Semiconductor device and lead structure. Angemeldet am 30. Juli 1959, veröffentlicht am 25. April 1961, Erfinder: Robert N. Noyce.
- ↑ I. M. Ross: The invention of the transistor. In: Proceedings of the IEEE. 86, Nr. 1, 1998, S. 7–28.
- ↑ R. G. Arns: The other transistor: early history of the metal-oxidesemiconductor field-effect transistor. In: Engineering Science and Education Journal. 7, Nr. 5, 1998, S. 233–240.
- ↑ Patent DE833366: Halbleiterverstärker. Angemeldet am 15. April 1949, veröffentlicht am 30. Juni 1952, Anmelder: SIEMENS AG, Erfinder: W. Jacobi.
- ↑ Wafer Level Through Silicon Via (TSV) for 3D Integration. In: International Technology Roadmap for Semiconductors 2009 Edition. Assembly and Packaging. 2009, S. 18–19 (PDF).
Kategorien:- Integrierter Schaltkreis
- Elektronische Schaltung
- Aufbau- und Verbindungstechnik der Elektronik
Wikimedia Foundation.